麦姆斯咨询 | 2021-12-17至2021-12-19 | 无锡新吴区
麦姆斯咨询根据近期MEMS封装进展及市场热点,邀请在MEMS产业中拥有丰富实践经验的科研学者及企业家,为大家传授MEMS封装知识及技术经验。
一、课程简介
MEMS(微机电系统),是指以微型化、系统化的理论为指导,通过半导体制造等微纳加工手段,形成特征尺度为微纳米量级的系统装置。相对于先进的集成电路(IC)制造工艺(遵循摩尔定律),MEMS制造工艺不单纯追求线宽而注重功能特色化,即利用微纳结构或/和敏感材料实现多种传感和执行功能,工艺节点通常从500nm到110nm,衬底材料也不局限硅,还包括玻璃、聚合物、金属等。由MEMS技术构建的产品往往具有体积小、重量轻、功耗低、成本低等优点,已广泛应用于汽车、手机、工业、医疗、国防、航空航天等领域。

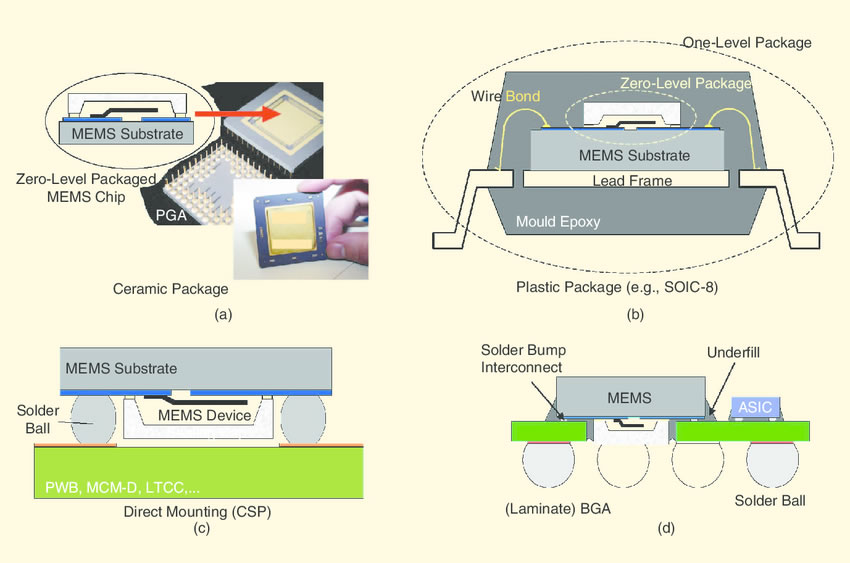
MEMS封装案例
MEMS器件的三维机械结构、产品设计和制造技术的多样性,决定了MEMS封装与传统IC封装存在诸多不同且更加复杂。从“消费类应用的低成本封装”到“汽车和航空行业的耐高温和抗恶劣气候的高可靠性封装”;从“裸露在大气环境下的开放式封装”到“需要抽真空的密闭式封装”——各种应用需求对MEMS封装提出了诸多挑战。同时,5G通信、自动驾驶、人工智能、物联网、增强现实(AR)/虚拟现实(VR)等也为MEMS产业带来新机遇,例如以滤波器为代表的射频MEMS迎来5G市场爆发;以微镜为代表的光学MEMS开拓汽车激光雷达商机;以气体传感器为代表的环境MEMS发掘人工智能物联网(AIoT)潜力。
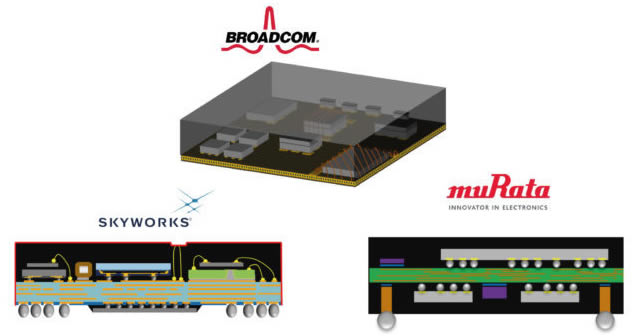
智能手机射频前端模组采用系统级封装(SiP)
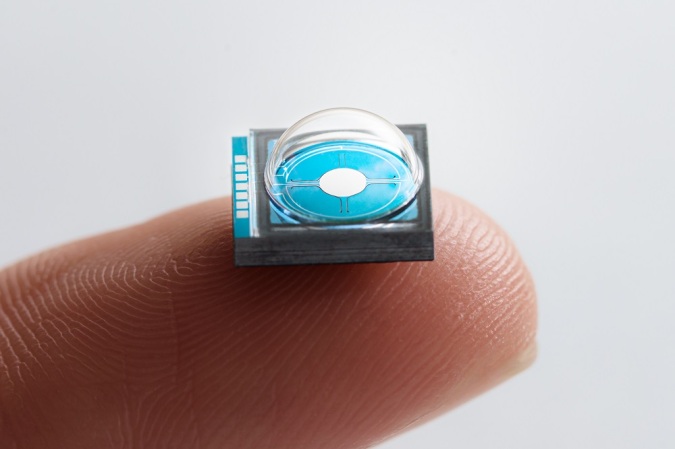
OQmented微镜采用独特的“气泡(Bubble)”MEMS晶圆级真空封装
MEMS封装除了包括IC封装的功能部分,即电源分配、信号分配和散热等,还需要考虑应力、气密性、隔离度、特殊的封装环境和引出等问题。例如,光学MEMS器件可能由于冲击、震动或热膨胀等原因产生的封装应力,造成光路对准发生偏移;MEMS陀螺仪的可动部件需要在真空环境中运动以减小摩擦,达到长期可靠工作的目标;红外探测器(微测辐射热计)应该采用真空封装技术,以减小其与周围空气之间的热导,同时还需要高透过率的红外窗口;MEMS麦克风可以根据各种应用需求采用不同开孔位置(例如顶部、底部、侧面)的封装,但同时也会影响器件的声学性能(例如信噪比)。
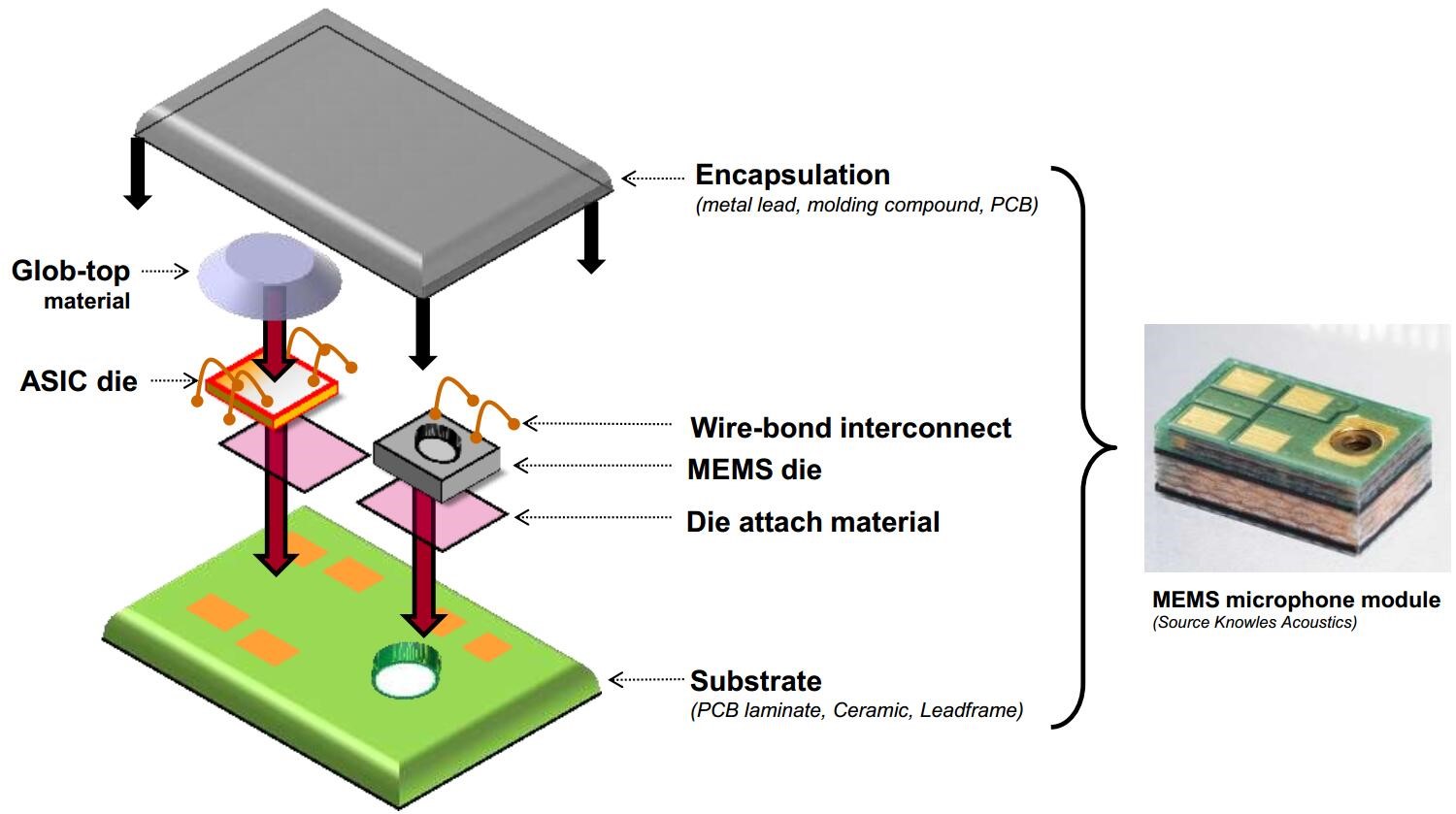
MEMS麦克风封装示意图
目前,MEMS产业正向多种传感器集成方向前进,形成“惯性、环境、光学”三大类组合传感器,具有三种典型的封装形式:密闭封装(Closed Package)、开放腔体(Open Cavity)、光学窗口(Open-eyed)。相比分立器件,组合传感器具有一些优势:(1)多种传感器可以共享ASIC芯片,共用封装外壳,能够降低产品成本;(2)如果两种传感器工艺相近,可以做成单芯片,能够极大减小传感器尺寸;(3)多种传感器数据经过滤波、融合,以及人工智能等算法处理,可以提高产品附加值,使得竞争对手难以模仿。

三大类组合传感器及封装形式
麦姆斯咨询根据近期MEMS封装进展及市场热点,邀请在MEMS产业中拥有丰富实践经验的科研学者及企业家,为大家传授MEMS封装知识及技术经验。课程内容包括:(1)MEMS封装概论;(2)晶圆级封装技术;(3)MEMS封装模拟与仿真;(4)真空封装技术;(5)MEMS封装可靠性与失效分析;(6)三维集成射频微系统封装;(7)模组级封装技术;(8)封装类EDA软件实战。
二、培训对象
本课程主要面向MEMS产业链上下游厂商的技术人员和管理人员,以及高校师生,同时也欢迎其他希望了解MEMS封装产业的非技术背景人员参加,如销售和市场人员、投融资机构人员、政府管理人员等。
三、培训时间
2021年12月17日~12月19日
授课结束后,为学员颁发麦姆斯咨询的结业证书。
四、培训地点
无锡市(具体地点以培训前一周的邮件通知为准)
五、课程内容
课程一:MEMS封装概论
老师:北京大学 教授 金玉丰
MEMS封装建立在IC封装基础之上,并衍生出新的封装技术和工艺,例如阳极键合、硅熔融键合、硅通孔(TSV)、玻璃通孔(TGV)等,进而反哺IC封装。MEMS封装可以分为“晶圆级封装、器件级封装、模组级封装”三个层级,具体应用需要根据“可制造性、成本、功能”进行权衡。本课程详细介绍MEMS封装基础知识和技术演进,并结合典型案例讲解技术要点,最后还提供相关学术和产业资源。
课程大纲:
1. MEMS封装概念及发展历史;
2. MEMS封装功能与要求;
3. MEMS封装分类、特点、难点;
4. MEMS封装技术综述;
5. MEMS封装案例讲解:惯性传感器、压力传感器、MEMS麦克风等;
6. MEMS封装的新要求、新挑战、新机遇;
7. MEMS封装相关学术与产业服务资源介绍。
课程二:晶圆级封装技术
老师:北京大学 教授 陈兢
晶圆级封装(WLP)是以晶圆为加工对象,在晶圆上同时对众多芯片进行封装和测试,之后再切割成单颗器件的一项先进封装技术。它使器件封装尺寸减小至芯片尺寸级别,生产成本大幅下降。晶圆级封装使业界能够从引线键合向倒装芯片、2.5D中介层和TSV技术以及高密度2D和3D扇出型方案演进。本课程全面讲解晶圆级封装技术及应用,最后阐述发展趋势。
课程大纲:
1. 硅晶圆直接键合技术;
2. 阳极键合技术;
3. 微帽封装技术;
4. 薄膜封装技术;
5. 晶圆级三维封装技术;
6. 基于丝网印刷技术的晶圆级封装技术;
7. 基于金属焊料的晶圆级封装技术;
8. 晶圆级MEMS聚合物封装技术;
9. 晶圆级封装技术发展趋势。
课程三:MEMS封装模拟与仿真
老师:浙江工业大学 教授 梁利华
在MEMS器件设计初期,可以利用建模的思想来模拟封装,寻找适合的材料和工艺,有利于降低生产成本并保证封装性能。并且,高效的建模和精准的仿真能够极大地提高工程师优化封装性能指标的效率,进而加快产品上市速度。本课程全面讲解MEMS封装模拟与仿真的基本理论、方法和实际应用,涉及结构设计、工艺模拟、材料测试、热管理、寿命预测等。
课程大纲:
1. 封装模拟与仿真概述;
2. 封装结构设计及力学仿真;
3. 封装工艺模拟及优化设计;
4. 封装材料测试与有限元模拟;
5. 封装热管理模型及热分析仿真;
6. 封装疲劳寿命预测、可靠性及失效分析;
7. 封装模拟与仿真技术发展趋势。
课程四:真空封装技术
老师:西北工业大学 教授 乔大勇
真空封装采用密封腔体提供高气密真空环境,使得MEMS器件的可动结构工作于真空环境下,可以提高MEMS器件的品质因数等性能。此外,集成适量的吸气剂并选择合适的激活条件是获得快速可靠的真空封装解决方案的关键因素。本课程讲解晶圆级和器件级两大类真空封装技术,并阐述真空度保持与测量技术,最后结合典型案例进行剖析。
课程大纲:
1. 真空封装概念及相关理论;
2. 晶圆级真空封装技术;
3. 器件级真空封装技术;
4. 真空度保持技术;
5. 真空度测量技术;
6. 真空封装案例详解:MEMS陀螺仪、红外探测器等。
课程五:MEMS封装可靠性与失效分析
老师:武汉大学 特聘副研究员 陈志文
MEMS产品质量与可靠性是终端设备正常使用的重要前提。因此,我们不仅要避免MEMS结构的失效,还需要保障MEMS封装的可靠性。MEMS封装可靠性测试涉及贴片(包括倒装焊、载带自动焊)、引线键合、封盖等工艺环节,并涵盖可靠性筛选和寿命试验。本课程从MEMS封装失效类型及机理出发,讲解可靠性测试分析技术,并介绍如何提高封装设计的可靠性。
课程大纲:
1. 典型封装失效类型;
2. 封装失效机理分析;
3. 封装可靠性测试规范及失效分析评价标准;
4. 封装可靠性测试分析技术及相关设备;
5. 封装设计的可靠性提高方法。
课程六:三维集成射频微系统封装
老师:厦门大学 副教授 马盛林
摩尔定律已接近物理极限,但未来电子信息系统将持续向更高集成度、更高性能、更高工作频率等方向发展,传统的集成封装技术逐渐难以满足新型系统集成要求。未来的技术发展趋势将是延续摩尔定律与超越摩尔定律结合起来,通过三维异构异质集成,实现更高价值的系统——微系统。射频微系统集成作为系统微型化趋势下的先进集成封装技术,已经成为引领装备发展、推动电子技术创新的重大基础技术,因此本课程内容不容错过!
课程大纲:
1. 三维集成射频微系统现状;
2. 高阻硅硅通孔(TSV)转接板技术;
3. 玻璃通孔(TGV)转接板技术;
4. 射频凸点(bump)与键合技术;
5. 封装内天线(AiP);
6. 三维集成射频微系统封装案例。
课程七:模组级封装技术
老师:苏州捷研芯电子科技有限公司 副总经理 王建国
为了适应电子产品微型化、便携式、高可靠性需求,模组级封装采用微互连、微组装等技术实现各种功能元器件的高密度集成,从而达到产品设计的功能需求。这项封装技术也是电子组装技术向微纳米尺度方向的延伸,在惯性传感、射频前端、光学传感等领域获得广泛应用。本课程详解多种模组级封装技术,并结合典型案例进行剖析,最后阐述发展趋势。
课程大纲:
1. LTCC基板封装:概念、工艺、材料及设备;
2. 柔性基板封装:概念、工艺、材料及设备;
3. SMT组装:概念、工艺、材料及设备;
4. MCM组装;概念、工艺、材料及设备;
5. 模组级封装案例详解:惯性导航模组、射频前端模组、激光雷达模组等;
6. 模组级封装技术发展趋势。
课程八:封装类EDA软件实战
老师:无锡飞谱电子信息技术有限公司 产品经理 徐金波
封装类EDA软件涉及封装设计、封装仿真以及SI/PI(信号完整性/电源完整性)分析等。随着先进封装技术发展及摩尔定律推进,封装形式走向高密度、高集成及微型化,因此对于封装的要求较大提高。为此,飞谱自研了的面向半导体封装的EDA软件工具:Modeler3D和QEM3D,拥有核心知识产权和100%源代码。本课程讲解如何利用上述工具进行封装建模与分析,并针对具体案例开展实战操作。
课程大纲:
1. 封装技术发展趋势及对EDA的挑战;
2. 飞谱Rainbow系列EDA软件介绍;
3. 封装级电源完整性分析;
4. 封装三维几何模型的提取:Modeler3D;
5. 封装键合引线的寄生参数提取:QEM3D;
6. 嵌入式电容的寄生参数提取:QEM3D;
7. 电源分配网络(PDN)寄生参数提取:QEM3D。
六、师资介绍
金玉丰,博士,北京大学教授、博导,现任中国微米纳米技术学会常务理事、深圳市微米纳米技术学会会长。他曾任微米纳米加工技术国家级重点实验室主任、北京大学微电子研究院副院长、先进技术研究院副院长等职。他曾任职于电子部55研究所,从事电子元器件科研与管理工作;1999年以来,任职于北京大学,主要从事微电子集成封装、MEMS传感器设计、加工、封装测试和应用开发等教学研究工作;2001-2004年作为高级访问学者在新加坡先进制造技术研究所进行为其三年的MEMS传感器、先进MEMS封装技术合作研究;2007年在香港应用科技研究院进行先进封装集成技术合作研究;2017年在德国弗朗霍夫协会电子纳米系统研究所(Fraunhofer ENAS)进行先进集成封装技术合作研究。他曾主持或参加国家重点科技攻关与基础研究项目二十余项,主持国家重大科技专项“TSV三维集成技术”研究课题,担任“三维集成技术基础研究”973项目技术首席。他出版《微米纳米器件封装技术》等中英文专著3部、译著2部,在期刊或会议上发表论文二百余篇。
陈兢,连续三年获得麦姆斯咨询“最受欢迎老师”,博士,苏州含光微纳科技有限公司创始人兼总经理,北京大学教授,中国微米纳米技术学会(CSMNT)副秘书长。1997年7月毕业于清华大学精密仪器与机械学系,获工学学士学位。同年进入清华大学微电子学研究所攻读博士学位,2002年7月毕业,获微电子学与固体电子学博士学位。2002年8月至2004年10月在美国密歇根大学从事博士后研究。2004年11月进入北京大学工作,任微电子学系副教授、教授,主要从事微纳加工、三维集成微系统等方面的研究。他主持863、国家自然科学基金重点项目等十余项国家级科研项目;发表学术论文120余篇;获得中国发明专利60余项;著有中英文学术著作6部。2014年创办苏州含光微纳科技有限公司,入选2015苏州工业园区科技首批重大科技领军人才、2015苏州市姑苏创新创业领军人才、2016江苏省双创计划人才。含光微纳在苏州纳米城建有4000平米研发和生产基地,专注于医疗耗材精密加工与注塑及微流控产品的定制研发生产,服务国内外企业客户300余家,是江苏省潜在独角兽企业、苏州工业园区上市苗圃企业、高瓴资本投资企业。
梁利华,博士,浙江工业大学教授、博士生导师,现任浙江工业大学余杭智能制造技术与装备研究院院长,兼职中国仿真产业联盟理事、浙江省力学学会副理事长、浙江省力学学会-力学与产业促进工作委员会主任委员、浙江省风机标委会副主任委员、华东基础力学与工程应用协会副理事长。他长期从事微电子封装仿真技术研究、柔性可穿戴电子技术研究和智能制造高端装备研发,发表高水平论文100余篇,获专利授权60余项(发明专利30余项),出版学术专著3本,出版教材2本,主持国家基金、省基金、省重大专项项目、重大军工项目等40余项。他还获得浙江省教学成果一等奖1项。在项目合作方面,与美国Fairchild半导体公司共建“浙江工业大学—美国Fairchild半导体公司微电子封装联合实验室”,担任实验室主任;与美国VITESSE半导体公司、北京强度所、华为、OPPO手机等开展封装可靠性技术合作。
乔大勇,连续三年获得麦姆斯咨询“最受欢迎老师”,长江学者特聘教授,西北工业大学博士生导师、教授。他是微机电系统(MEMS)领域资深专家,先后主持包括国家自然科学基金和国家重点研发计划在内的科研项目14项,主要研究方向为微光机电系统(MOEMS)和微纳制造工艺。他出版国家级规划教材《微机电系统》一部,出版国家学术著作出版基金资助专著《微机电系统(MEMS)制造技术》一部。
陈志文,武汉大学工业科学研究院副研究员、IEEE会员、IEEE电子封装学会会员。本科毕业于华中科技大学,博士毕业于拉夫堡大学(Loughborough University)。他长期从事电子制造相关领域的研究与工作,主要从事先进电子封装可靠性研究,并积极开发新的表征和仿真方法。近五年来,他主持纵向课题2项(其中国家自然科学基金青年项目1项)、校级课题3项、横向课题1项,参与纵向课题3项、横向课题2项,发表学术论文25篇,申请发明专利14项,其中已授权发明专利2项、PCT 2项、软件著作权1项,获得国防科技进步三等奖一项(排名第二)。
马盛林,麦姆斯咨询2019年度“优秀老师”,2012年7月毕业于北京大学,获微电子学与固态电子学专业博士学位。2012年8月起在厦门大学机电工程系工作,2017年受聘为厦门大学副教授,2018年受聘为博士生导师,2018年1月起至现在受聘为北京大学微米/纳米加工技术国家级重点实验室客座研究员。他主要从事IC先进封装(TSV、3D SIP、MEMS)、三维射频微系统集成、植入电子微系统封装等方向研究工作,承担多项国家级重点课题任务,包括02国家科技重大专项、国家自然科学基金项目等;累计发表论文30余篇(SCI/EI检索)、申请发明专利20余项,其中1项PCT专利,拥有2项美国发明专利和10余项中国发明专利授权,4篇学术论文获得国际学术会议最佳论文奖。
王建国,南京大学硕士,苏州捷研芯电子科技有限公司创始人之一、副总经理,苏州捷杰传感技术有限公司总经理,兼任西安交通大学副研究员。他曾任职于AMD、AOS、星科金朋、晶方科技等半导体公司技术、研发和市场等部门。他拥有20年多半导体集成电路和MEMS行业经验,在IC和MEMS传感器封测领域有深厚的技术和管理积累。他带领捷研芯团队建立了国内首条专业声波滤波器封装代工线,对国内外最新MEMS器件和模组封装技术及工艺均具有丰富的实践经验(MEMS麦克风、压力传感器、喷墨打印头、流量传感器、基因测序芯片、射频滤波器、射频模组等);特别在Flip chip、WLCSP、Bumping、Fan-out、SiP微系统模组技术领域有领先的研究经验。他申请专利30项,目前已授权24项。
徐金波,无锡飞谱电子信息技术有限公司产品经理,拥有近20年的应用工程师(AE)和产品工程师(PE)从业经历,在结构设计及热仿真领域积累了丰富的实战经验,目前主要从事电热耦合仿真软件设计,以及三维电磁场全波分析软件开发和管理工作。飞谱电子致力于为电子系统设计提供先进的建模、仿真和验证解决方案,其开发的专业软件工具为芯片设计与制造、高速电子封装和系统集成厂商解决信号及电源完整性、电磁兼容及干扰等设计挑战。飞谱电子于2021年2月获得华为哈勃投资。
七、培训费用和报名方式咨询
请发送电子邮件至PENGLin@MEMSConsulting.com,邮件题目格式为:报名+MEMS封装技术培训+单位简称+人数。
麦姆斯咨询
联系人:彭女士
电话:17368357393
E-mail:PENGLin@MEMSConsulting.com